大模型引领的AIGC是第四次工业革命的起点,具备从底层改变各行业规则的能力。2023年成为AI大模型元年,大模型的预训练和生成能力以及多模态多场景应用能力大幅提升。其中,算力芯片作为最重要的生产力工具,已成为全球科技竞争的焦点。
美国近年来频繁出台针对中国半导体行业的制裁政策,试图遏制中国在芯片领域的崛起。然而,这一系列制裁不仅未能阻挡中国半导体产业的发展,反而激发了中国在芯片技术自主创新方面的决心和动力。在这一背景下,先进封装技术作为一种能够有效提升芯片性能的手段,逐渐成为国产AI芯片实现弯道超车的关键突破口。
01 后摩尔时代,先进封装大势所趋

半导体封装的主要目的是电气连接和保护芯片。先进封装技术与传统封装技术主要以是否采用焊线来区分。传统封装一般利用引线框架作为载体,采用引线键合互连的形式进行封装。而先进封装引脚以面阵列引出,采用倒装等键合互连的方式来实现电气连接,并发展出多种封装技术。
封装技术的不同直接影响芯片的性能、功耗和体积。因此,封装在决定电子设备整体功能中起着重要作用。随着对更小、更快、更高性能芯片需求的增长,先进的封装技术变得尤为重要。
“后摩尔时代”,随着集成电路工艺制程的越发先进,对技术端和成本端均提出了巨大挑战,先进封装快速发展。
先进封装根据不同需求延伸出不同方案,契合不同场景特点,包含倒装封装、晶圆级封装、系统级封装、2.5D/3D封装等,主要通过平面与空间上的革新实现连接的密集化、堆叠的多样化和功能的系统化。随着新技术演进,以2.5D/3D为代表的先进封装工艺已深入高性能AI芯片生产。
2.5D/3D先进封装工艺中,包含Bump(凸块)、RDL(重布线)、Interposer(中介层)和 TSV(硅通孔)等关键要素,均涉及具有前道工艺特点的工艺流程,与传统封装相比,具有更高的技术门槛和进入壁垒。因此,进入先进封装时代后,全球封测竞争格局发生变化,先进封装市场不再只有封测玩家,晶圆厂也参与其中并发展迅速。
以台积电为例,3D Fabric是台积电旗下的先进封装技术品牌,涵盖了多种2.5D和3D封装技术。其中,CoWoS平台将先进逻辑及高带宽存储器HBM整合,在人工智能、机器学习及数据中心中广泛应用。
CoWoS(Chip On Wafer On Substrate)技术是台积电在2.5D封装上的重要技术平台。CoWoS由CoW和oS组合而来:借助微凸块(μBumps)技术先将芯片通过Chip on Wafer(CoW)的封装制程连接至硅晶圆(Si interposer),再把CoW芯片与基板(Substrate)连接,整合成CoWoS。
其中硅中阶层先由TSV技术形成联通上下的通孔,再使用RDL形成高密度布线,因此信号可以经由硅中阶层高速传输。CoWoS非常适合需要大量并行技术、处理大量数据向量以及需要高内存带宽的应用场景。
特朗CoWoS封装结构示意图
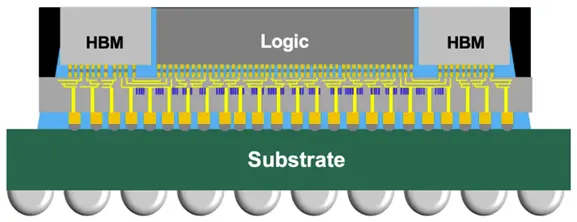
资料来源:台积电官网
台积电CoWoS技术为2.5D封装中的领先技术,相关技术方案也成为行业内学习的主要方向。三星和英特尔也将先进封装技术作为发展重点,都已完成2.5D/3D封装部署。三星I-Cube作为异质整合技术,I-Cube可将一个或多个逻辑芯片(如CPU、GPU等)和多个存储芯片(如HBM)整合连接在中介层顶部。英特尔在2.5D封装中引入EMIB(Embedded Multi-Die Inter connect Bridge)技术,其结构上看,没有引入额外的硅中介层,而是只在两枚裸片边缘连接处加入了一条硅桥接层(Silicon Bridge),并重新定制化裸片边缘的I/O引脚以配合桥接标准。
尽管如此,CoWoS当前仍为AI算力芯片最主流的封装方案,英伟达、博通、Marvell、谷歌、亚马逊、AMD等均广泛采用CoWoS技术,其中英伟达需求占比过半。Trend Force预计台积电2024年CoWoS总产能增长150%,2025年年底达到月产能近4万片,2026年预计达到9-11万片/月。
根据Yole预测,先进封装在整体封装行业中的占比将从2022年的47%提升至2028年的58%;预计到2029年,先进封装市场规模将提升至695亿美元,2023-2029年CAGR超10%。其中,AI算力需求拉动2.5D/3D封装高增,预计到2029年,市场规模将达276亿美元,是先进封装中市场规模最大、增速最快的市场。
02 先进封装:国产AI芯片破局点

自2018年中美贸易战爆发以来,美国对中国的芯片技术封锁逐步从单一企业打击演变为全产业链压制。
2020年12月,美国将中芯国际列入“实体清单”,限制中芯国际14nm及以下制程的扩产,国产先进制程代工受限。
2022年10月,美国发布《先进计算与半导体制造出口管制新规》,从先进半导体设备封锁、英伟达高端算力芯片断供、人才流动阻断,进行“三位一体”的技术限制,对中国半导体产业造成结构性冲击,而这种冲击不断升级。
2024年11月,台积电迫于美国的压力,拟对中国大陆停供7nm及更先进制程芯片,满足以下条件之一的AI芯片供应将受影响,(1)芯片面积在300mm2及以上;(2)使用了高带宽存储HBM或2.5D封装CoWoS工艺;(3)晶体管数大于300亿个。此政策旨在进一步从上游芯片代工和封装环节遏制国产AI芯片的生产制造环节。
2025年1月15日,美国商务部工业与安全局(BIS)宣布修订出口管理法规(EAR),要求提供与高级计算集成电路相关的更多尽职调查程序。一款芯片如果其采用了16/14nm节点及以下先进制程,并且其最终封装内包含有300亿个或更多的晶体管,将会受到限制,相关的前端芯片制造商和OSAT公司将被禁止对华出口此类芯片。
到2027年,晶体管数量将扩大至350亿个以内;到2029年或之后,则进一步扩大至400亿个以内。台积电亦宣布自2025年1月31日起,如果16/14nm及以下制程的相关产品,若不在美国BIS白名单中的“approved OSAT”进行封装,且台积电没有收到该封装厂的认证签署副本,这些产品将被暂停发货。
这一系列的制裁政策使得中国企业获取和制造高端AI芯片的难度大幅增加,但同时也促使中国加快自主研发和国产替代的进程,而先进封装有望成为技术破局点:
(1) 突破制程限制
高端光刻机受限导致国内代工厂在先进制程芯片制造上面临技术瓶颈。基于先进封装的多芯粒集成技术可以提升芯片性能,突破美国先进制程的封锁。通常意义上,单位面积晶体管数量越多,芯片性能越强。先进封装技术可以通过集成工艺,将多个小芯片集成在一起,帮助芯片跨越1至2个制程工艺节点,提升整体系统性能;
(2) 异构计算优化
先进封装还可将不同工艺节点的计算模块,如逻辑芯片、存储单元、模拟电路等进行系统级封装,实现能效比的显著提升;
(3) 互联瓶颈突破
采用硅基中介层或混合键合技术,将芯片间互联带宽提升1-2个数量级,缓解“内存墙”对算力的制约。
这些技术路径的组合应用,可使国产AI芯片在前道工艺制程受限的情况下,将芯片性能的竞赛从单一制程指标转向“架构创新+异构集成+系统优化”的多维比拼,国产AI芯片有机会依托庞大的市场应用场景和快速迭代的工程能力,大幅缩小技术代差,打破技术瓶颈。
03 国产先进封装行业的发展现状与前景

近年来,中国在先进封装技术上取得了显著进展,国内封测龙头企业纷纷布局。长电科技面向Chiplet异构集成应用推出XDFOI高密度扇出型封装方案。通富微电推出融合了2.5D、3D、MCM-Chiplet等技术的先进封装平台VISionS。华天科技拥有3D Matrix平台,以Fan-out封装技术为基础,具备一定的TSV能力,主要应用于5G通信、医疗、物联网等领域。
此外,国内市场中也涌现出一批成长型企业,积极布局先进封装领域,但在2.5D/3D等高端先进封装领域仍是蓝海市场,新进入者存在发展机遇。
同时,产业链也对高端先进封测环节提出了更高的要求。
首先,先进封装厂需要设计服务能力的深度构建。随着异构集成和系统级封装技术的普及,封装设计与芯片前端设计的协同性成为关键。具备EDA工具自主开发能力、多物理场仿真平台以及系统架构优化经验的封装厂,能够从产品定义阶段介入,提供信号完整性分析、热力学模拟、功耗优化等定制化设计服务。
例如,针对带有HBM高带宽存储芯片的2.5D封装,需通过硅中介层布线优化实现高密度互连设计;而在Chiplet异构集成中,则需通过先进封装设计解决不同工艺节点的裸芯互连与电磁兼容问题。这种“设计-工艺协同优化"能力使封装厂从代工服务商升级为系统级解决方案提供者。
其次,未来国内晶圆制程将形成中国路线与中国节点,这就要求封装厂能够充分理解并衔接前道晶圆厂工艺,针对前道遗留下来的力学、散热等关键问题进行针对性的优化,以便在材料选择、工艺窗口设定以及缺陷分析等环节实现精准控制。并且,先进封装中所涉及的Bump(凸块)、RDL(重布线)、Interposer(中介层)和 TSV(硅通孔)等工艺流程,均涉及前道工艺。因此对前道晶圆制造工艺的深度认知将成为先进封装的技术底座。
同时,随着算力需求呈现指数级增长,单一封装技术已无法满足从移动终端到超算中心的差异化场景需求,完整工艺平台可满足半导体产业的多维变革。
例如,在三维集成领域,需掌握TSV深孔刻蚀(深宽比>10:1)、混合键合及超薄晶圆处理等核心技术;在平面扩展方向,则需突破2μm线宽RDL重布线、翘曲控制等高密度扇出工艺;同时还需要光电共封装(CPO)等异质集成能力。这种平台化架构使封装厂商能灵活迭代技术路线,快速响应市场需求,形成技术护城河。
因此,具有设计服务提供能力、能充分理解晶圆厂工艺、有完整工艺平台的企业将更具有竞争力。
综上所述,美国芯片制裁已成为推动中国半导体技术发展的催化剂,先进封装将发挥越来越关键的作用。尽管这些制裁带来了诸多挑战,但也加速了中国在封装技术上的自主创新和突破。这无论是在增强国家技术自主权,还是在应对未来技术挑战方面,均具有深远的战略意义。在政策引导、市场驱动、技术创新的协同作用下,先进封装有望成为国产AI芯片换道超车的核心引擎,为国产AI芯片提供了跨越制程鸿沟的战略支点。